6層ビルドアップ基板の層構成

回路おこしを行った実績です。
6層ビルドアップ基板の層構成2種類
A:中層の、両面基板を作成してからビルドアップ工法による6層基板
両面BVH基板+ビルドアップ
B:6層の、中4層基板を作成してから、ビルドアップ工法による6層基板
4層BVH基板+ビルドアップ
基板製造行程の概略を記載しました。
参考まで。
回路おこし実績資料

A:中層の両面基板を作成してから、ビルドアップ工法による6層基板

製造工程の概略
1:コア層の両面基板に穴をあけて、THを成形。
2:THの中を穴埋め後、蓋の部分を含めてメッキをかける。
3:エッチングにてL3層とL4層にパターンを成形する。
4:プリプレグAと銅箔L2L5面の銅箔を成形。
L2−L3間、L4−L5間をレーザーでVia加工
メッキにて層間を接続
5:プリプレグBと銅箔L1L6面の銅箔を成形。
L1−L2間、L5−L6間をレーザーでVia加工
メッキにて層間を接続
5:全層の貫通穴をあけて穴の壁面にメッキをかける
6:L1L6層のパターンを成形
7:レジストの成形
8:シルク文字の成形
9:外形加工
B:中4層基板を作成してから、ビルドアップ工法による6層基板

製造工程の概略
1:コア層の両面基板にパターンをエッチングにて成形。
2:プリプレグAとL2層とL5層をプレスにて張り付け。
3:L2層〜L5層に貫通穴をあけて、THを成形する。
貫通穴を穴埋めし、穴の表面にも銅箔を成形する。
4:エッチングにてL2、L5層のパターンを成形する。
5:プリプレグBと銅箔L1L6面の銅箔を成形。
L1−L2間、L5−L6間をレーザーでVia加工
メッキにて層間を接続
6:貫通穴をあけて、THを成形。
L1L6層にパターンを形成
7:レジストの成形
8:シルク文字の成形
9:外形加工
ビルドアップ基板のViaサイズ
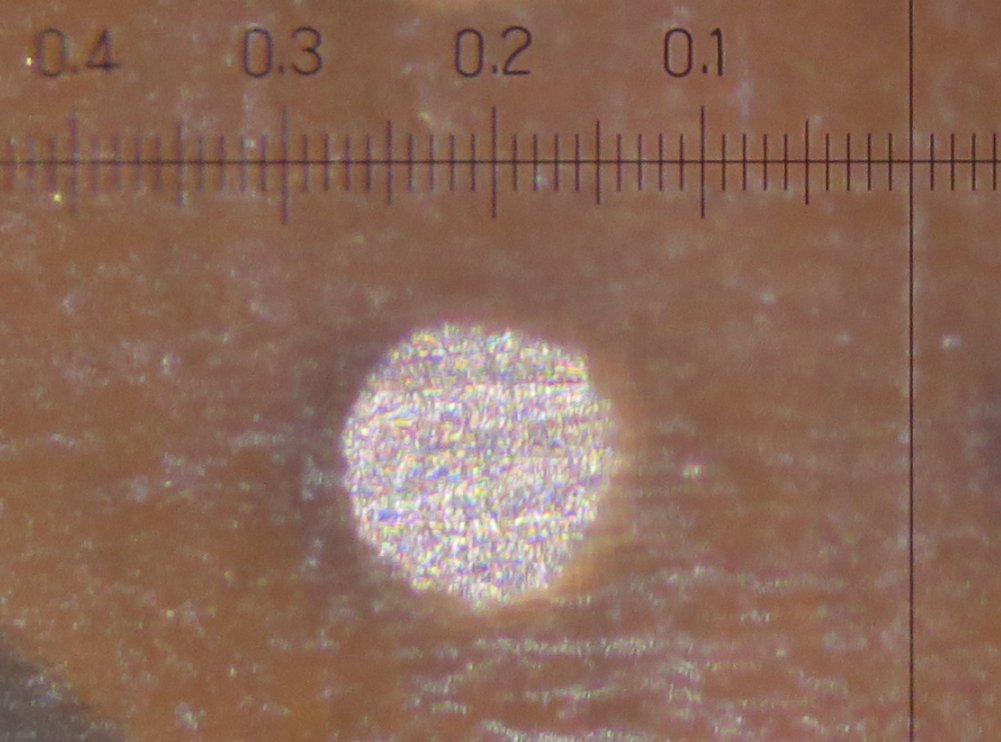
ビルドアップ基板のViaサイズは、
0.13mm
見落としてしまいそうなサイズです。
回路おこしで見てきた4層基板の層構成3種類です。
製造工程の概要解説あります。
関連ページ
- 回路おこし こぼれ話1 見えないほどの小さな部品
- 極小部品の0603等、うまくとれるかが問題でした。 このような小さな部品でも、何とかクリア出来るようになりました。
- 回路おこし こぼれ話2 問題 コンデンサはどれですか
- どれがコンデンサなのか、わかりますか。
- 回路おこし こぼれ話2 回答 コンデンサはどれですか
- 回路おこしの進め方のなかで、 コンデンサとバリスタの区別、判断方法。
- 回路おこし こぼれ話3 問題 何層基板でしょうか
- 回路おこしを進める時に、一番気になるのが、層数と層構成です。層間のプリプレグの厚さも気になるところです。
- 回路おこし こぼれ話3 回答 何層基板でしょうか
- 断面から、層数と銅箔厚さ、プリプレグの厚さを確認して進めます。 基板端面で全ての銅箔が見られれば良いのですが、ない場合も多々あります。
- 回路おこし こぼれ話4 ストリップライン
- 両面実装基板で、ストリップラインを構成する場合、最低でも6層以上の層構成が必要となる。ここでは、前の8層基板の数値を例にインピーダンスを計算してみます。
- 回路おこし こぼれ話5 プレスフィット端子
- 車載関係で使用されているプレスフィットピン、プレスフィットコネクタをまとめています。 スルホール壁面への食い込み方が、すごいものもあります。
- 回路おこし こぼれ話6 部品下の濡れた跡
- 問題:部品下に光っている濡れた様な跡があります。これは何でしょうか。
- 回路おこし こぼれ話6 回答 濡れた跡は何だろう
- 大型リフロー部品としては、リレー、端子等があります。半田量を確保するため、メタルマスク開口部との関係を記載しました。
- 回路おこし実績 4層基板のいろんな層構成
- 今までに見てきた4層基板の層構成が3種類あります。層構成と製造工程を開設してあります。
- 回路おこし実績 8層ビルドアップ基板の層構成2種類
- 他社製品の基板分解調査(ティアダウン・回路図おこし)は、製品開発の前段階で回路調査することにより、性能・技術力・原価等を把握し、自社製品との比較分析が可能となります。